Atomlagenabscheidung
Konforme Schichten auf allen Geometrien
Die Atomlagenabscheidung (ALD) ist ein spezialisiertes zyklisches CVD-Verfahren, das für seine Fähigkeit bekannt ist, äußerst oberflächenkonforme Schichten mit beispielloser Präzision in der Schichtdicke abzuscheiden.
- Zyklisches CVD-Verfahren
- Ermöglicht oberflächenkonforme, präzise Schichtdicken
- Einsatz in der Halbleiterelektronik und Optik
Dank dieser einzigartigen Eigenschaften hat sich die ALD zu einem unverzichtbaren Instrument in der Halbleiterelektronik und Optik entwickelt. Insbesondere in Anwendungen, bei denen Kontrolle auf atomarer Ebene und gleichmäßige Abdeckung kritisch sind, bietet die ALD Lösungen, die mit herkömmlichen Abscheidungstechniken schwer zu erreichen wären.
Erfahren Sie mehr über diese zuverlässige und präzise Technik in der Dünnschichttechnologie.
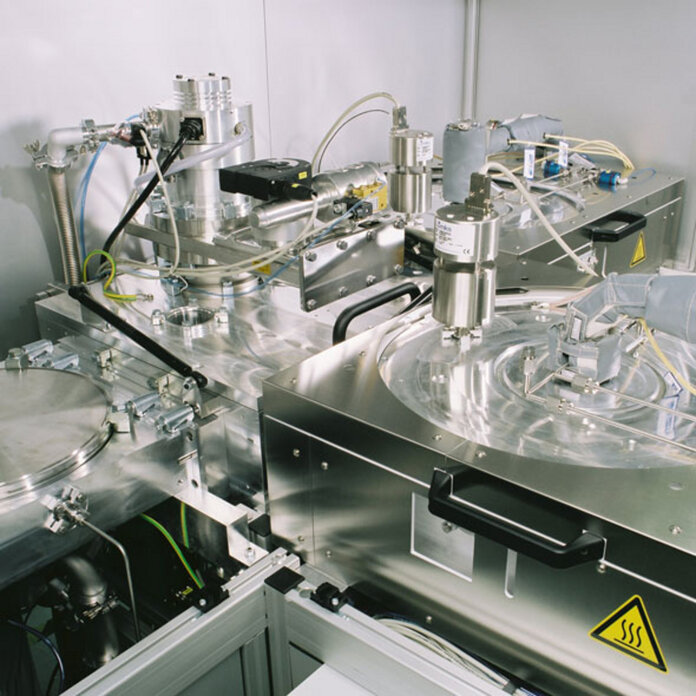
So funktioniert´s
So funktioniert die Atomlagenabescheidung
Die Atomlagenabscheidung (ALD) ist eine Technik, um sehr dünne Schichten auf Oberflächen aufzutragen. Dieses Verfahren gehört zur Familie der CVD-Methoden. Bei der ALD wird die Schicht durch wiederholte, zyklische Reaktionen an der Oberfläche gebildet.
Hauptsächlich wird diese Methode in der Halbleiterelektronik verwendet, zum Beispiel, um spezielle Schichten in bestimmten Transistoren zu erzeugen. Die Technik wird allerdings auch in anderen Bereichen verwendet, etwa bei der Herstellung von kleinen mechanischen Systemen, Barrierebeschichtungen oder optischen Schichten.
Anders als bei typischen CVD-Verfahren, bei denen die chemische Reaktion überall im Raum stattfindet, erfolgt die Reaktion bei der ALD nur direkt auf der Oberfläche. Es ist ein Schritt-für-Schritt-Prozess: Zuerst wird ein Stoff auf die Oberfläche aufgebracht, der dort reagiert. Dann wird dieser Stoff entfernt und ein anderer Stoff aufgebracht, der dort wieder reagiert. Dies wird wiederholt, bis die gewünschte Schichtdicke erreicht ist. Nach jedem Schritt wird die Kammer gereinigt. In jedem dieser Zyklen wird nur eine sehr dünne Schicht abgelagert. Dank der ALD können auf komplexen Oberflächen gleichmäßige, sehr dünne Schichten erzeugt werden. Dies geschieht bei relativ niedrigen Temperaturen zwischen 150 °C und 400 °C. Manchmal werden spezielle Techniken oder Stoffe verwendet, um die benötigte Temperatur noch weiter zu senken.
Haupteinsatzgebiet war und ist die Halbleiterelektronik, zum Beispiel das Erzeugen von High-k-Gate-Schichten in MOSFETs. Allerdings kommen die Vorzüge der ALD-Technologie zunehmend auch in anderen Branchen zum Tragen, unter anderem bei der Herstellung von MEMS, Barriereschichten, optischen Beschichtungen oder von funktionalen Schichten auf Partikeln oder in Kapillaren.
Die Atomlagenabscheidung bietet gegenüber anderen Dünnschichtabscheidungstechniken mehrere Vorteile:
- Atomare Präzision: Die ALD ermöglicht die Abscheidung von Materialien Schicht für Schicht, wodurch exakte und kontrollierte Schichtdicken auf atomarer Ebene erreicht werden können.
- Oberflächenkonformität: Das ALD-Verfahren gewährleistet eine hervorragende Abdeckung, selbst auf strukturierten oder hoch topographischen Oberflächen, was zu gleichmäßigen und homogenen Schichten führt.
- Geringe Verarbeitungstemperatur: Viele ALD-Prozesse können bei Temperaturen durchgeführt werden, die niedriger sind als bei anderen CVD-Verfahren, was sie für temperaturempfindliche Substrate geeignet macht.
- Breite Materialauswahl: Die ALD kann für eine Vielzahl von Materialien, einschließlich Metallen, Oxiden und Nitriden, verwendet werden, wodurch es für unterschiedlichste Anwendungen vielseitig einsetzbar ist.
- Hohe Qualität und Reinheit: Dank des sequenziellen Prozesses der ALD werden hochreine Schichten mit minimalen Defekten oder Verunreinigungen produziert.
- Skalierbarkeit für industrielle Anwendungen: Trotz seiner atomaren Präzision kann die ALD effizient skaliert werden, um in industriellen Produktionsumgebungen eingesetzt zu werden, insbesondere in der Halbleiterelektronik.
Durch diese Eigenschaften hat sich die ALD als ein Schlüsselverfahren in vielen Bereichen der Materialwissenschaft und Technologie etabliert.
Die FHR designt und baut ALD-Beschichtungsanlagen nach den spezifischen Wünschen unserer Kunden. Von der Konfiguration der Kammer bis zu den Heiz- und Kühlmethoden kann alles individuell angepasst werden. Das Angebot umfasst Plattformen für 100, 150 und 300 Millimeter ebenso wie ALD-Module zur Integration in Cluster-Anlagen. Darüber hinaus sind auch Sonderanlagen auf Basis der ALD-Technologie möglich.
Vakuumbeschichtungsanlagen
Erfahren Sie, wie unsere Vakuumbeschichtungsanlagen in verschiedenen Branchen Hochleistungsbeschichtungen ermöglichen. Unsere Experten zeigen Ihnen, wie Sie unsere Technologien für Ihre Projekte optimal nutzen können.
Weitere Technologien und Beschichtungsverfahren
Der richtige Partner an Ihrer Seite
Gemeinsam die Zukunft gestalten – mit zuverlässigen und hochwertigen Beschichtungslösungen der FHR:
- Branchenführende Qualität: Unsere Vakuumbeschichtungsanlagen sind auf höchste Präzision und Langlebigkeit ausgelegt.
- Maßgeschneiderte Lösungen: Wir bieten individuelle Lösungen für Ihr Beschichtungsprojekt, die Ihren speziellen Anforderungen gerecht werden.
- Innovative Methoden und Technologien: Mit unserer langjährigen Erfahrung und Expertise bei der Vakuumbeschichtung setzen wir neue Standards.
- Engagierter Kundenservice: Unser erfahrenes Team steht Ihnen jederzeit zur Verfügung, um Ihre Fragen zu beantworten und Sie bei Ihren Projekten zu unterstützen.
Entdecken Sie die vielfältigen Möglichkeiten unserer Vakuumbeschichtungstechnik und vertrauen Sie auf die FHR als Ihren zuverlässigen Partner für herausragende Beschichtungslösungen. Kontaktieren Sie uns, um mehr zu erfahren und gemeinsam Ihre Projekte zu realisieren.


Ihr Ansprechpartner
Sie haben Fragen?
Sie wollen mehr über Dünnschichttechnologie erfahren oder sich ganz allgemein zu unseren Vakuumbeschichtungsanlagen und unserem Beschichtungsservice beraten lassen? Dann melden Sie sich bei uns – unser Expertenteam beantwortet gerne all Ihre Fragen.