Mikroelektronik der Zukunft
Hochflexibles Sputter-Beschichtungssystem für elektronische Funktionsschichten
APPLIKATION
Seit der Einführung von Personal Computern und dem Internet ist die Mikroelektronik in unserem Alltag präsent. Wir erleben seither einen rasanten technologischen Fortschritt in der Computertechnik und damit einen Wandel unserer Lebensverhältnisse. Selbstfahrende Autos, künstliche Intelligenz, Quantencomputer und das Internet der Dinge stehen kurz vor dem Durchbruch. All diese Zukunftsthemen benötigen neben Softwareentwicklung auch Fortschritte in der Hardware und somit Anlagen für deren Herstellung.

ANFORDERUNGEN AN DIE ANLAGE
Die Anlage dient der Forschung und Entwicklung in der Mikroelektronik und muss deshalb für alle heutigen und zukünftigen Anforderungen gewappnet sein. Entsprechend muss die Anlage praktisch alles können, was man in Sputteranlagen kombinieren kann: Eignung für Wafer bis zu 200 mm Durchmesser, kurze Zeit zwischen Substrateinlegen und Prozessstart, Aktivierung bzw. Ätzen der Oberfläche durch Ionenbeschuss, Heizen des Substrats bis 600 °C, DC- und HF-Bias des Substrats, bis zu fünf Sputterquellen und damit verschiedene Targetmaterialien, die einzeln oder gleichzeitig per Co-Sputtern sowohl in DC als auch HF und sowohl direkt als auch reaktiv gesputtert werden können. Der Winkel des Targets und der Target-Substratabstand sollen zudem einstellbar sein und natürlich darf die Anlage für ihre Aufstellung im Reinraum nur minimal Platz in Anspruch nehmen. Schließlich muss die Anlage komplexe Rezepte automatisiert absolvieren können, alle Prozessdaten kontinuierlich aufzeichnen und verschiedene Nutzerlevel ermöglichen.
LÖSUNG DER ANFORDERUNGEN
Die FHR.Star.100-PentaCo besteht aus einer kleinen Einzelsubstratschleuse mit eingebautem Roboterarm zur Beladung der benachbarten Prozesskammer unter Vakuum. In der Prozesskammer liegt das Substrat auf einem Drehteller mit eingebautem Strahlungsheizer und zuschaltbarem HF- und DC-Bias. Im Kammerdeckel sind fünf Positionen für Sputterquellen angeordnet, so dass in der Anlage ohne Wartungsarbeiten eine entsprechend große Anzahl an Targetmaterialien verfügbar ist. Für Wartungszwecke wird der Prozesskammerdeckel pneumatisch geöffnet. Wie bei FHR-Anlagen üblich, verfügt auch diese Anlage über eine umfassende Automatisierung mit Zugriff auf alle Komponenten und über eine komfortable Rezeptsteuerung.
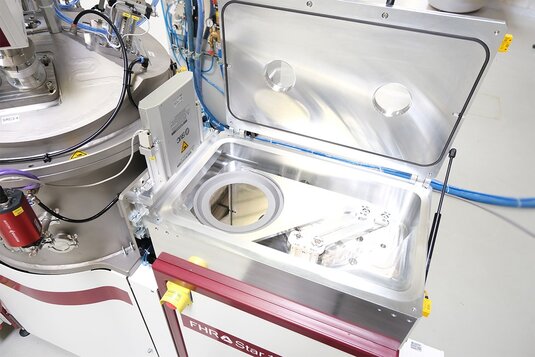
DIE BESONDERHEITEN DER FHR.Star.100-PentaCo
- Substratheizung bis 600 °C
- Substratbias (HF und DC)
- Bis zu 5 verschiedene Targetmaterialien gleichzeitig verfügbar
- Minimaler Footprint
- Rezeptgesteuerte Beschichtung mit Kontrolle über alle Anlagenkomponenten und Prozessdatenlogging

Ihr Ansprechpartner
Sie haben Fragen?
Sie wollen mehr zu unseren Projekten und individuellen Einsatzmöglichkeiten wissen? Unser Segment Manager Electronics Oliver Lossau hilft Ihnen gerne weiter. Melden Sie sich bei uns.